|
|
||||||||||
1970年代前半 Poly Si/Oxide/SiNの成膜に減圧CVDを採用 〜プロセス技術〜 |
||||||||||
| 熱CVD(Chemical Vapor Deposition)は、石英などでできた反応管内で加熱したウェーハ上に、形成しようとする薄膜の成分を含む原料ガスを供給し、ウェーハ表面或いは気相での化学反応により薄膜を形成する技術である。1970年代半ば頃まで用いられてきた常圧CVD装置ではウェーハは熱板上に平置きにされ、その上に均一にガスを供給する必要があったため、一度に膜形成できる枚数が少なく、生産性に問題があった。1970年代前半に、横型拡散炉内にガスの流れに対してウェーハを垂直に立てて膜を形成することにより生産性を大幅に向上した減圧CVD装置が開発された。減圧CVD はLPCVD(Low Pressure CVD)ともいわれ、大気圧の1/100〜1/10000の低い圧力で膜形成するため、ガス分子同士が衝突する機会が減り、広範囲にわたりガス濃度が均一になり、垂直に立てたウェーハの間隙にも活性ガスが均一に導入され、膜の成長も均一になる。はじめ、poly Siやシリコン窒化膜(Si3N4)の形成法として確立され、ついでOxide(SiO2)膜形成にも用いられるようになった。このPoly Si膜形成技術の開発によりシリコンゲートMOSトランジスタ技術が実用化され、またSi3N4膜は選択酸化法によるアイソレーション技術であるLOCOS(Local Oxidation of Silicon)に適用され、その後のMOSLSIの高密度化・高集積化に大きく寄与した。 2001年時点の減圧CVD装置のメーカ別シェアでは、東京エレクトロンが1位、日立国際電気が2位で、この2社で70%以上を占めた。 |
||||||||||
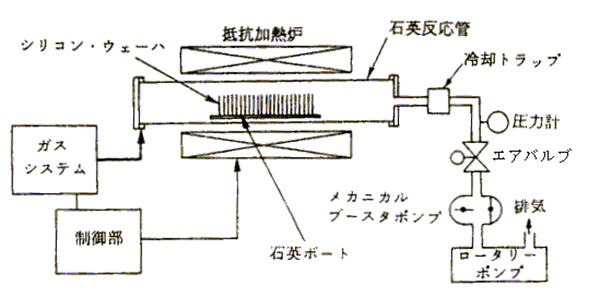 |
||||||||||
| 減圧CVD装置の構造1) | ||||||||||
|
【参考文献】 1)実用真空技術総覧編集委員会編、実用真空技術総覧、P682、産業技術サービスセンター(1990) 【移動ページ】 プロセス技術/該当年代へ 【最終変更バージョン】 rev.000 2010/10/8 |