|
|
||||||||||
1970年代後半 等方性プラズマエッチングの採用 ~プロセス技術~ |
||||||||||
| 等方性のプラズマエッチングで初めてのドライエッチングの登場となる。それまでは、SiやSiNなどSi系のエッチングはフッ硝酸系、燐酸系の溶液によるエッチングによっていた。しかし溶液によるエッチングには、①エッチング均一性があまり良くないという問題、②高温のエッチングのため、レジストの耐性がないという問題、さらに、③エッチング終点の判別が難しい、等の問題があった。また、レジスト剥離では、①特にAL配線パターニング後のレジスト剥離での毒性の高い有機系剥離液の使用、②イオン注入の導入により、溶液では剥離出来ない工程の出現、等が問題であった。これらの問題の大部分は、1970年代に登場したプラズマエッチングにより解決していった。 プラズマエッチングにより、ポリシリコンやSiNの精密エッチングが可能となったことで、シリコンゲートやLOCOSといったプロセスモジュールの量産化への追い風となった。特に、トランジスタのWやLに直結する精密エッチングは、あわせて開発された終点検出技術によるところも大きい。 等方性プラズマエッチングは、①直接ウェーハチャンバー内にプラズマを起こす方式、②別の場所でプラズマを起こし、生成したラジカルをウェーハチャンバーに輸送する方式(ケミカルドライエッチング)の2つに大別される。いずれも、プラズマにより活性化したエッチングガス分子(原子)をウェーハ表面にさらすことで化学反応によりエッチングするのが原理で、ウェーハチャンバーは真空に引いた状態でエッチングガスを導入し、マイクロ波などによりプラズマを生成する。エッチングガスには、フッ素系ガス、アッシャーには酸素が広く用いられた。また、プラズマ自体や活性化したエッチング分子(原子) または反応生成物による発光をモニターすることで終点の自動検出が可能となり、自動化が進んだ。 ケミカルドライエッチングは、材料間でのエッチングの選択性が高いことが特徴のひとつであり、SiO2に対してSiを選択的にエッチングできたり、無機材料に対して有機材料を選択的に除去できるなどの特徴を利用したアプリケーションに活用された。 半導体プロセスにプラズマを用いる試みは1960年代から行われていたが、実際に実用化され始めたのは1970年代に入ってからであり、数社からバレル型のプラズマエッチング装置が発売されている。用途は主にレジスト剥離であったが、日本では、東京応化が1971年にプラズマを用いたレジスト剥離装置を発表している。また、ウェーハをプラズマから分離したケミカルドライエッチング装置は、1978年に徳田製作所( 現;芝浦メカトロニクス(株) ) より発売されている。 |
||||||||||
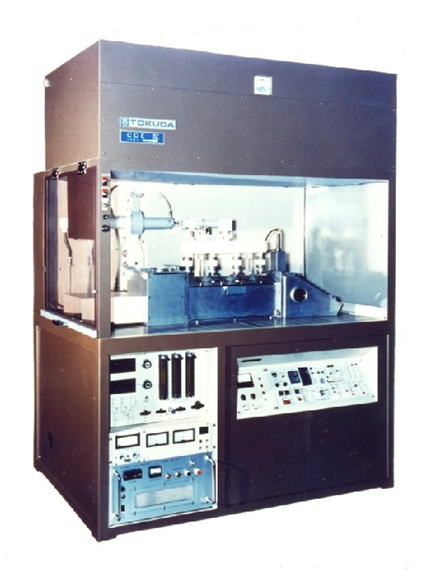 徳田製作所のケミカルドライエッチング装置 CDE-4 (提供:芝浦メカトロニクス) |
||||||||||
|
【参考文献】 【移動ページ】 プロセス技術/該当年代へ 【最終変更バージョン】 rev.001 2010/10/26 |