1978年
反応性イオンエッチング(RIE)装置
~装置・材料/エッチ・洗浄・研磨~
反応性イオンエッチング法(Reactive Ion Etching : :RIE)は1974年に初めて日電バリアン(後の日電アネルバ、現在はキヤノンアネルバ)で開発され[1]、1978年に反応性イオンエッチング(RIE)装置(DEA-503)が販売された[2]。 100㎜ウェーハを7枚投入して、フロロカーボン系のガスを使用してシリコンをエッチングする装置である。さらに日電バリアンは超LSI研究組合と共同して、6個のプロセス室を持つ、マルチチャンバー方式の枚葉型エッチング装置(DEA-3016)を開発した。なお、日電バリアンはこれを反応性スパッタエッチングと呼んだが、後にIBMが呼称したRIEが一般的となった。
半導体製造において、反応性ガスのプラズマによるエッチングはレジスト除去[3]やポリシリコンのエッチング[4]に使われていた。反応性ガスのプラズマ中の中性ラジカルによるエッチングは等方性(深さ方向・横方向のエッチング速度が同等)であるため、エッチング後の断面形状は傾斜角が生じる。一方、RIEはスパッタ法[5]の原理を用いて、ウェーハに垂直方向の電界を印加してプラズマ中のイオンのみを引き出してエッチングする方法であり、断面形状がウェーハ面に垂直となる異方性エッチングが可能になった。これにより、エッチングマスクのレジスト寸法に忠実なパターン形成が可能になり、より精度の高い微細加工ができるようになった。以後、イオン発生源やイオンの制御法に様々な方式が開発されて行くが、RIEは半導体エッチングの基本方式となった。

図1 最初のRIE装置(DEA-503) (キヤノンアネルバ提供)
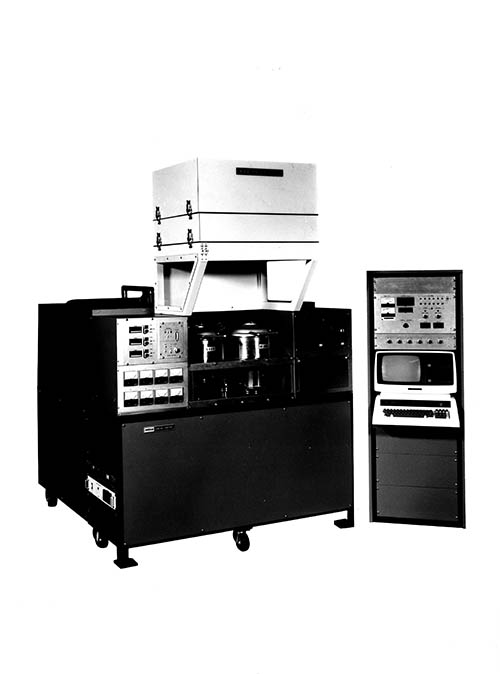
図2 マルチチャンバー型枚葉式RIE装置(DEA-3016) (キヤノンアネルバ提供)
【参考文献】
[1] N. Hosokawa, R. Matsuzaki and T. Asamaki “RF Spatter Etching by Fluoro-Chloro-Hydrocarbon
Gases” Rroc. 6th International Vacuum Congress, Kyoto 1974
[2] 半導体歴史館
開発物語:ドライエッチング装置
[3] 半導体歴史館:1960年代後半:プラズマアッシャー
[4] 半導体歴史館:1977年:プラズマエッチング装置
[5] 半導体歴史館:1970年代前半:スパッタ―装置
[移動ページ]
■ 装置材料 該当年代へ
■歴史館の他のページへ
| HOME | ようこそ | 業界動向
| 応用製品 | 集積回路 |
個別半導体他 | プロセス技術
|
| パッケージング技術 | 装置・材料
|
[最終変更バージョン]
Ver.002 2019/12/18
