1984年
測長SEM(CD-SEM)
〜装置・材料/計測・検査〜
1980年代、縮小投影露光方式によってサブミクロン領域の光リソグラフィによる微細加工が可能になった[1]。 しかしこの微細度は光学的な解像限界近傍であったために、それまでの光学顕微鏡方式による寸法計測・管理が問題になってきた。 走査型電子顕微鏡(SEM)は光学顕微鏡より焦点深度と解像度が優れているが、電子線照射による帯電によって像の劣化やトランジスタ素子の損傷が生じるので 寸法検査には不向きであった。
1984年、日立(現日立ハイテクノロジーズ)はSEM方式における問題点を解決して、CD-SEM(Critical Dimension Scanning Electron Microscope)装置(S-6000 CD-SEM)を開発した[2][3]。 同社が1972年に開発したFE-SEM[4]の電界放射(Field Emission)型電子銃を用いて、約1KeVの低加速電圧にして帯電と素子損傷を防止し、 高分解能計測を可能にした。これに、レンズ磁場を通して二次電子を検出するスルー・ザ・レンズ方式の採用で信号の対称性を確保して、 高スループットの自動検査装置にしたものである。CD-SEMの登場により、サブミクロン領域でのCDコントロールが可能になった。
日立(現:日立ハイテクノロジーズ)は、その後もレンズ磁場をウェハ側に発生して焦点距離を短縮するセミインレンズ方式の採用(1989年)、 電子放出の安定性に優れたSE(Schottky Emission)電子銃を高分解能にするりターディング法の採用(1994年)などにより分解能の向上を進めた「5」。 CD-SEMは比例縮小する半導体技術の発展に不可欠な検査装置となった。
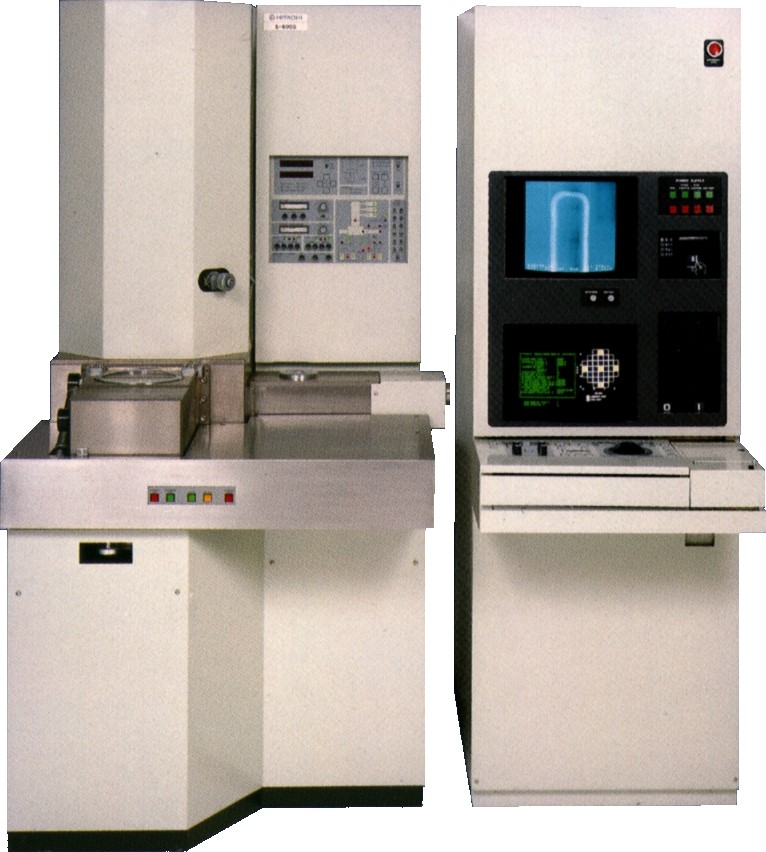
図 測長SEM (S-6000 CD-SEM)
(日立ハイテクノロジーズ提供)
【参考文献】
[1] 半導体歴史館;1980年代前半:微細化が進みリソグラフィはステッパに移行
[2] 日立評論 67 (1985)
[3] Toru
Ikegami et al, “Evolution and Future of Critical Dimension Measurement System
on Semiconductor Processes” Hitachi Review Vo.l60 No.5 (2011)
[4] 半導体歴史館;1970年代:電界放射型走査型電子顕微鏡(FE-SEM)
[移動ページ]
■ 装置材料 該当年代へ
■歴史館の他のページへ
| HOME | ようこそ | 業界動向
| 応用製品 | 集積回路 |
個別半導体他 | プロセス技術
|
| パッケージング技術 | 装置・材料
|
[最終変更バージョン]
Ver.002/ 2019/12/18
