1980年代
枚葉クラスターツール
〜装置・材料/成膜・エッチ〜
半導体の前工程製造においては、ウェーハ露光を除き、洗浄・拡散・成膜・エッチングは複数枚のウェーハを一括処理するバッチ処理装置が主であった。エッチング工程では1978年に日電バリアン(現キヤノンアネルバ)が枚葉式RIE(反応性イオンエッチング)をマルチチャンバー化して処理能力を高める装置を開発した。
1980年代後半に、高密度プラズマ・イオン源を用いてエッチング速度を高めたRIE方式が開発されて枚葉化が進み、更に成膜工程の一部が枚葉化された[2]。
エッチング・成膜工程の枚葉化の進展とともに、複数のプロセス・チャンバーを備えたマルチチャンバー方式が本格化した。1984年、General SignalsのDrytechは4チャンバーの枚葉ドライエッチ装置(Quad)を開発し、1987年に複数工程の連続処理を可能にするクラスターツールとした。同年、AMATは枚葉式のマルチチャンバー・プラットフォーム(Precision
5000)を採用し、CVDやドライエッチングの枚葉プロセス・チャンバーを搭載可能にした。例えば、図1のように、MOSFETのゲート電極加工した後に低濃度のドレイン層のイオン打ち込みを行い、クラスターツールによって絶縁膜のCVDと異方性ドライエッチングの連続処理でサイドウォールスペーサーを形成することができる(この後、スペーサーをイオン打ち込みのマスクとして高濃度のドレイン層を形成し、LDD(Lightly
Doped Drain)を形成する)。マルチチャンバー化による枚葉プロセスのスループット向上から、複数工程の連続処理を可能にするクラスターツール化によって、コンタミネーション・フリーのプロセス品質の向上と工程間の待ち時間を解消する生産性向上が図られるようになった。
図2に典型的なクラスターツールの構造を示す。トランスファー・チャンバーの搬送ロボットでプロセスウェーハをロードロック室から枚葉プロセス・チャンバーに移載して処理する。異なるプロセス・チャンバーを設けて、チャンバー間でウェーハ移載すれば連続処理が可能になる。クラスターツールはその後も進化を続けた。1990年には、AMATが2つのトランスファーを連結させて、高真空のスパッタリングとCVD・ドライエッチングやRTP(Rapid
Thermal Processing)などの低圧のプロセスの連続処理を可能にするクラスターツール(Endura 5500)を発表した。特に、VLSIの微細化が進むとともに多層配線では金属表面のコンタミネーションによる層間の接触抵抗が問題になるにつれて、表面クリーニングと金属膜形成を連続処理するこの種のクラスターツールが有効になった。
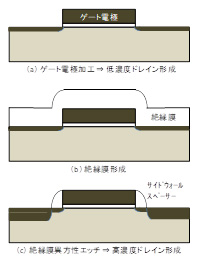 |
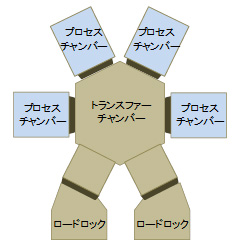 |
図1LDD形成の連続処理 | 図2クラスターツールの構造 |
【参考文献】
[1] 半導体歴史館:1970年代後半: プラズマCVD装置 [工事中]
[2] 半導体歴史館:1978年: 反応性イオンエッチング(RIE)装置
[移動ページ]
■ 装置材料 該当年代へ
■歴史館の他のページへ
| HOME | ようこそ | 業界動向
| 応用製品 | 集積回路 |
個別半導体他 | プロセス技術
|
| パッケージング技術 | 装置・材料
|
[最終変更バージョン]
Ver.002/ 2019/12/18
