|
|
||||||||||
1990年代前半 HDPエッチ&CVD(ECR、ICP) 〜プロセス技術〜 |
||||||||||
| HDP(High Density Plasma=高密度プラズマ)技術は1990年代前半に台頭した。微細化が進み0.35μm世代以降では微細な深溝掘り(ディープトレンチキャパシタやシャロートレンチアイソレーション)の為、より高密度なプラズマエッチャーが必要となり、1989年アネルバ(ECR方式エッチャー)、1990年日立製作所(マイクロ波プラズマ方式エッチャー)、1992年ラムリサーチ(TCP方式エッチャー)、1993年アプライドマテリアルズ(ICP方式エッチャー)などと発売が続いた。 高密度化する事でより早く、より深く、より垂直にエッチングする事が出来るようになったが、プラズマダメージのコントロールが重要になった。 また、微細化した溝の埋め込みの為、同じ高密度プラズマ+バイアス電圧を応用したCVD装置も提案され、1995年ラムリサーチがECR方式CVDを発売するなど各社CVDへの応用を試みた。中でも高密度CVD中のバイアス電圧によるスパッタエッチ効果を利用した埋め込みCVDは、山型の独特なデポジション形状の埋め込み特性のゆえに従来のリフロー式CVDを凌駕し、広く使用された。 高密度プラズマCVDでは高真空が必要とされ大型で高負荷に耐えるターボポンプの開発・進化も促した。 尚、これらの技術はプラズマダメージの影響を受けにくいMEMSの世界で数百ミクロンレベルのエッチングや厚膜デポジション用として急速に取り入れられた。 |
||||||||||
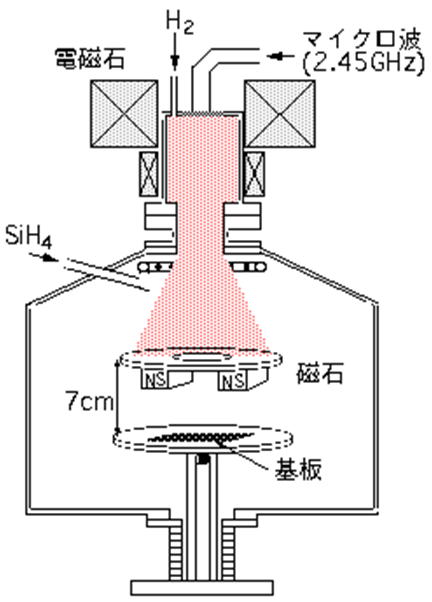 ECR(電子サイクロトロン共鳴)CVDの概略図 |
||||||||||
|
【参考文献】 1)SEAJ創立20周年社団法人化10周年記念誌 2)特許庁 標準技術集 ECRスパッタ装置 http://www.jpo.go.jp/shiryou/s_sonota/hyoujun_gijutsu/semicon_vacuum_tech/1_7_2.htm 【移動ページ】 プロセス技術/該当年代へ 【最終変更バージョン】 rev.003 2013/7/30 |