2001擭
300mm僂僃乕僴僾儘僙僗偺僗僞乕僩
乣憰抲丒嵽椏乣
1960擭崰偵0.75僀儞僠(栺20噊)岥宎偺Si僂僃乕僴偑嫙媼偝傟傞傛偆偵側偭偰偐傜丄儉乕傾偺朄懃偵廬偭偰廤愊搙傪憹壛偝偣偨悢惽夞楬偺惗嶻偵偼僂僃乕僴偺戝岥宎壔偑梫媮偝傟丄2001擭偵偼300噊Si僂僃乕僴偵傛傞ULSI惗嶻偑奐巒偝傟偨(恾1)[1]丅 1990擭戙屻敿偐傜300噊Si僂僃乕僴偍傛傃偙傟傪梡偄傞敿摫懱惢憿憰抲偺崙嵺昗弨壔妶摦偑恑傔傜傟[2]丄1990擭戙枛偵偼300噊僂僃乕僴懳墳偺敿摫懱惢憿憰抲丒嵽椏偺僒僾儔僀僠僃乕儞偑妘棧偝傟偰偄偨丅埲屻丄壛岺儗儀儖90nm埲壓偺ULSI偼傎偲傫偳300噊僂僃乕僴偵傛偭偰惗嶻偝傟傞傛偆偵側偭偨丅
偨偩丄僷儚乕敿摫懱丄MEMS丄僙儞僒傗壛岺儗儀儖110nm埲忋偺VLSI側偳偺惗嶻偵偼8僀儞僠(200噊)僂僃乕僴偑堷偒懕偒巊梡偝傟偨丅廬棃偺戝岥宎壔偼慜悽戙偺僂僃乕僴偐傜戝岥宎僂僃乕僴傊彊乆偵曄傢偭偰備偔堏峴偱偁偭偨偑丄300mm僂僃乕僴傊偺戝岥宎壔偱偼8僀儞僠僂僃乕僴偵傛傞敿摫懱惗嶻儔僀儞傕暲峴偟偰憹偊懕偗偰偄傞(2020擭帪揰)丅
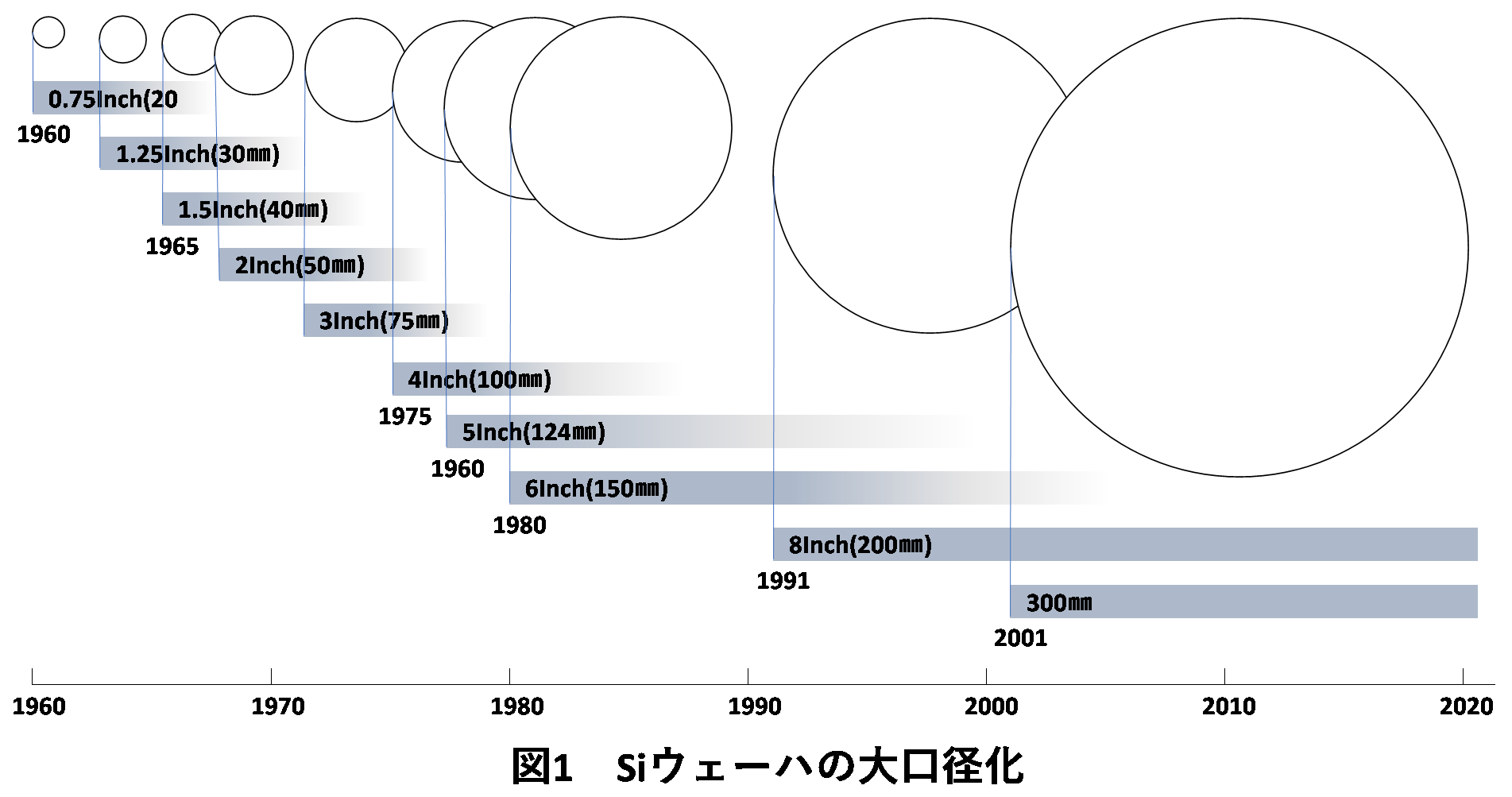 |
亂嶲峫暥專亃
[1]2000擭戙慜敿丗300mm僂僃乕僴傊偺堏峴
[2]1990擭戙屻敿丗300噊昗弨壔妶摦
[堏摦儁乕僕]
仭 憰抲嵽椏丂奩摉擭戙傊
仭楌巎娰偺懠偺儁乕僕傊
| HOME | 傛偆偙偦 | 嬈奅摦岦
| 墳梡惢昳 | 廤愊夞楬 |
屄暿敿摫懱懠 | 僾儘僙僗媄弍
|
| 僷僢働乕僕儞僌媄弍 | 憰抲丒嵽椏
|
[嵟廔曄峏僶乕僕儑儞]
Ver.001 2020/12/25
